Как Soft X-Ray литография может изменить производство микросхем: взгляд на B-EUV
Полупроводниковая индустрия движется вперед стремительными темпами: чипы становятся все компактнее, производительнее и энергоэффективнее, подпитывая инновации от искусственного интеллекта [1] до автономного транспорта. Но EUV-литография, несмотря на свои достижения, сталкивается с серьезными препятствиями: сложные оптические системы, колоссальные затраты и физические ограничения в разрешении.
И тут на горизонте появляется литография B-EUV (Beyond EUV), основанная на мягком рентгеновском излучении [2]. При длине волны 6,5–6,7 нм она позволяет формировать линии порядка 3–4 нм, что делает ее потенциальной альтернативой Hyper-NA EUV-системам. В первую очередь за счет меньшей числовой апертуры в B-EUV. Соответственно, не требуется много зеркал, да и оптика получается проще и дешевле. Давайте разберем, в чем ее уникальность, какие задачи уже решены и что за барьеры еще предстоит преодолеть.

Что такое B-EUV и почему она важна
Литография — ключевой процесс производства микросхем, в котором свет переносит микроскопические шаблоны на кремниевую подложку, формируя транзисторы и проводники. Методы глубокого ультрафиолета (DUV) с длиной волны 193 нм уперлись в физические ограничения [3]: напрямую они не могут формировать узоры меньше ~40 нм, а дальнейшее масштабирование стало возможным только благодаря усложненным приемам вроде иммерсионной литографии и многократных экспозиций. EUV с длиной волны 13,5 нм открыла путь к техпроцессам 7 нм и ниже, но ее оборудование оказалось чрезвычайно дорогим (более [4] 200 млн долларов за установку), энергозатратным (500–600 кВт) и требующим десятков зеркал [5] с высочайшей точностью полировки.
B-EUV использует мягкое рентгеновское излучение с длиной волны 6,5–6,7 нм, при котором энергия фотонов достигает 185–190 эВ против 92 эВ у EUV. Более короткая волна дает выше разрешение и ниже — рассеивание. Группа Майкла Цапатсиса из Университета Джонса Хопкинса показала [6], что плазма на основе гадолиния может генерировать такое излучение и формировать линии шириной порядка 3–4 нм. Благодаря этому B-EUV работает с меньшей числовой апертурой (NA), упрощая оптику и скращая затраты, что делает технологию перспективной для узлов 2 нм и ниже.
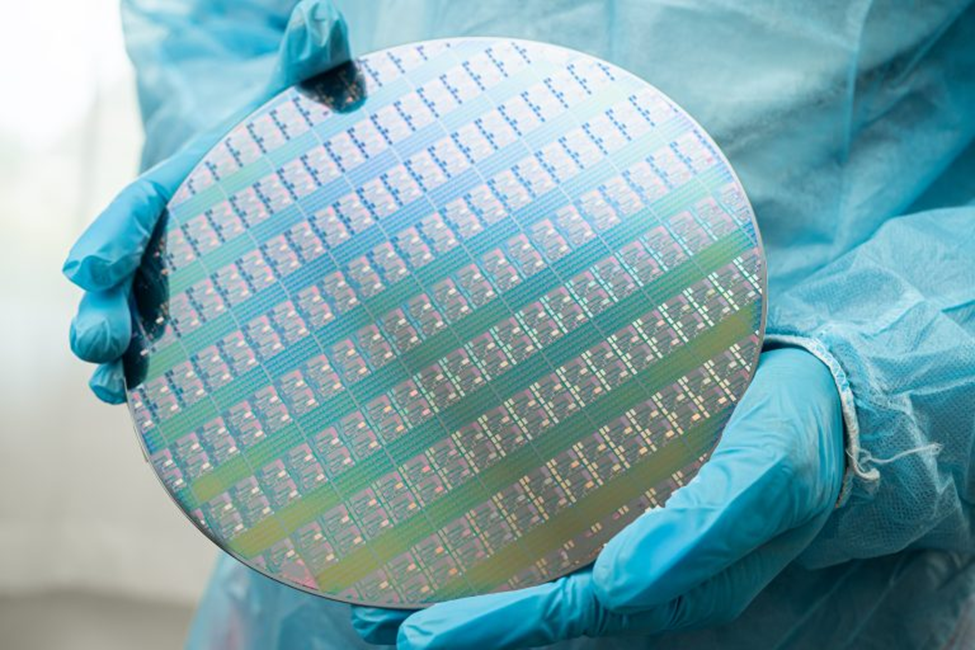
B-EUV позволяет [8] оптимизировать производство, уменьшая количество экспозиций и дефекты. Фотоны высокой энергии запускают каскад реакций [9] в фоторезистах, формируя узоры на молекулярном уровне с толщиной слоев 10–20 нм (против 30–50 нм у EUV). Это ускоряет травление и повышает точность. Кроме того, B-EUV можно настраивать под разные длины волн, и она подходит не только для чипов, но и для нанооптики или медицинской визуализации.
B-EUV меняет литографию: более короткая длина волны открывает путь [7] к тонким фоторезистам, что снижает энергопотребление и облегчает обработку пластин. В экспериментах удалось достичь разрешения меньше 5 нм без дополнительных хитрых приемов, которые в EUV приходится применять — например, многократных экспозиций или специальных масок. По оценкам IRDS, можно будет производить [10] чипы с плотностью до 10^9 транзисторов на мм² — основу для компактных устройств с обучающимися ИИ-моделями и интеграцией квантовых процессоров в обычную электронику.
Чем B-EUV отличается от EUV
B-EUV использует мягкое рентгеновское излучение с длиной волны около 6,5 нм, что теоретически позволяет достигать более высокого разрешения, чем у EUV на 13,5 нм. Исследователи из Университета Джонса Хопкинса показали [11], что новые фоторезисты на основе металлоорганических структур (aZIF) можно наносить методом химического жидкостного осаждения со скоростью порядка 1 нм/с, обеспечивая равномерные пленки, подходящие для работы с такими длинами волн. Это подтверждает, что B-EUV может стать реальным инструментом для будущих техпроцессов, хотя стабильные результаты на уровне 3–4 нм пока остаются целью, а не достигнутым стандартом.
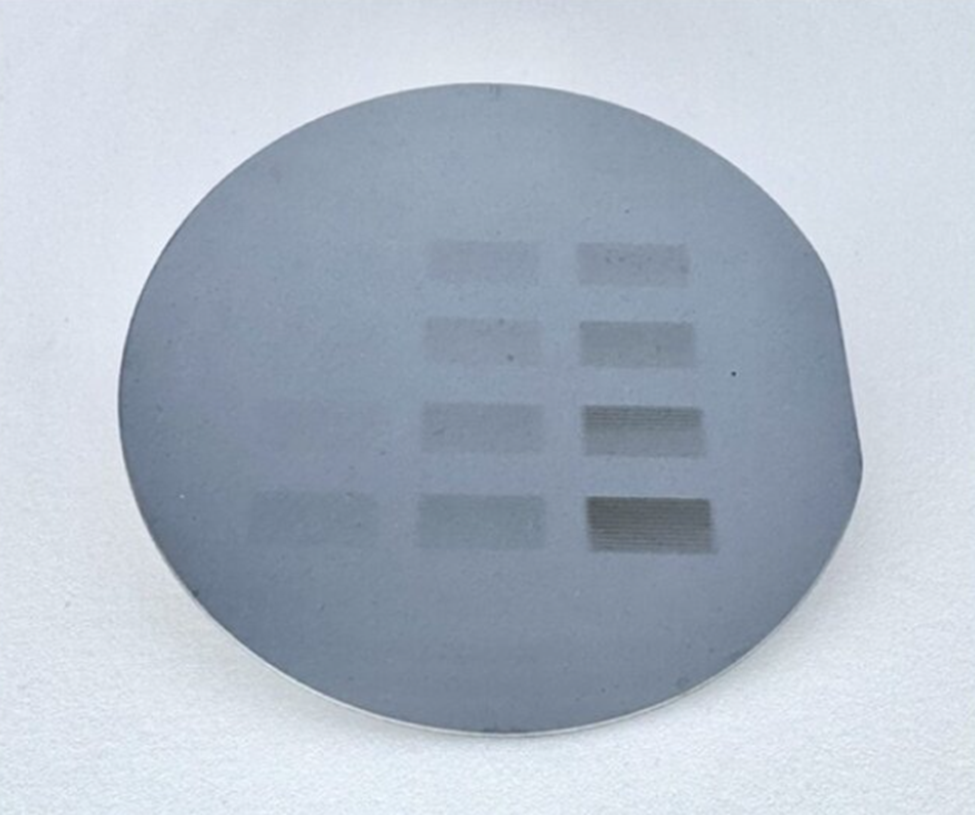
Источники света у EUV и B-EUV различаются. В EUV для получения излучения используют оловянную плазму, возбуждаемую мощными CO₂-лазерами. При этом большая часть энергии теряется, а микрочастицы олова загрязняют камеру и ухудшают работу оптики. В B-EUV планируют применять другие материалы, например гадолиний. Он дает излучение на длине волны около 6,5 нм. Как и EUV, B-EUV требует глубокого вакуума, так как мягкое рентгеновское излучение активно поглощается воздухом, но эти задачи решаются с помощью герметичных камер, уже созданных для EUV. Перспективно, что B-EUV может обеспечить более высокое разрешение для новых транзисторных структур, включая GAA-архитектуру, где возможности EUV постепенно приближаются к пределу.
B-EUV может упростить литографию. Если EUV требует сложных масок и дополнительных приемов, то более короткая волна B-EUV позволяет получать четкие узоры без лишних шагов. Это дает шанс ускорить производство и снизить количество ошибок при создании чипов.
Решенные проблемы: металлоорганические фоторезисты и оптика
Фоторезисты остаются слабым местом литографии. В EUV традиционные полимеры плохо поглощают свет и требуют больших доз. В B-EUV исследователи из Университета Джонса Хопкинса предложили [11] использовать металлоорганические каркасные структуры (MOF/ZIF), которые лучше реагируют на излучение. Их можно наносить методом химического жидкостного осаждения (CLD) со скоростью около 1 нм/с на 300-мм пластины, что быстрее и дешевле традиционных способов. Такой подход дает гибкость и может использоваться в разных производственных процессах.
Оптика — еще одна область, где B-EUV требует новых решений. В EUV используются молибден-кремниевые мультислойные зеркала, но на длине волны около 6,5 нм они почти не отражают свет. Поэтому исследователи рассматривают [8] альтернативные покрытия, например на основе бор-нитрида или лантана, наносимые ионно-лучевыми методами. Параллельно ведутся работы с фоторезистами нового типа (MOF/ZIF), которые можно наносить методом CLD. Пока все это остается на уровне лабораторных испытаний, но прогресс уже заметен.
Правда, не решены проблемы масштабирования: CLD нужно адаптировать для тысяч пластин в час, а пеликлы для мягкого рентгена требуют доработки. Тем не менее успехи в химии и оптике создают фундамент для чипов с атомной точностью, готовя B-EUV к «выходу в люди».
Когда B-EUV станет реальностью
Перевести B-EUV из лаборатории в промышленность будет непросто. Первые опытные установки ожидаются в течение 3–5 лет, а массовое внедрение прогнозируется ближе к 2030–2035 годам. Главные барьеры — отсутствие [12] стабильных источников света мощностью около 500 Вт, а также необходимость [13] новых защитных пленок для масок и фотошаблонов, которые должны пропускать излучение почти без потерь. Есть сложности и с программным обеспечением: поведение [14] фоторезистов при облучении приходится просчитывать на уровне атомов и электронов, а это намного сложнее, чем стандартные модели OPC. К тому же оборудование остается очень чувствительным к вибрациям на фабриках. До конца десятилетия лидером останется Hyper-NA EUV (TSMC планирует запустить первые линии в 2026 году), но к началу 2030-х B-EUV может занять заметную долю рынка — до 20% в сегменте самых передовых чипов, особенно если энергопотребление EUV-сканеров (500–600 кВт) станет критичным фактором.
Прогресс поддерживают крупные компании: Intel и Samsung исследуют [15]металлоорганические фоторезисты и новые химические процессы, хотя промышленных установок B-EUV пока не существует. Разработку ускоряет [16] консорциум Blue-X, в который входят десятки участников, но риски сохраняются — например, возможный экспортный контроль на рентгеновские лазеры. Если эти барьеры удастся снять, B-EUV сможет стать альтернативой Hyper-NA EUV и уменьшить зависимость [17] отрасли от монополии ASML. Дополнительным преимуществом является энергоэффективность: B-EUV потребляет примерно на 30% меньше энергии, что важно в условиях ужесточающихся экологических требований.
В долгосрочной перспективе B-EUV может сделать производство микросхем более доступным. Если технология выйдет на промышленный уровень, ее станут использовать не только крупнейшие игроки, но и новые фабрики в развивающихся странах. Это даст рынку больше конкуренции и снизит зависимость от нескольких монополистов. А сама индустрия получит более гибкий и энергоэффективный инструмент для развития.
Автор: BiktorSergeev
Источник [18]
Сайт-источник BrainTools: https://www.braintools.ru
Путь до страницы источника: https://www.braintools.ru/article/19982
URLs in this post:
[1] интеллекта: http://www.braintools.ru/article/7605
[2] мягком рентгеновском излучении: https://ru.wikipedia.org/wiki/%D0%A0%D0%B5%D0%BD%D1%82%D0%B3%D0%B5%D0%BD%D0%BE%D0%B2%D1%81%D0%BA%D0%BE%D0%B5_%D0%B8%D0%B7%D0%BB%D1%83%D1%87%D0%B5%D0%BD%D0%B8%D0%B5
[3] физические ограничения: https://www.spiedigitallibrary.org/journals/journal-of-micro-nanolithography-mems-and-moems/volume-10/issue-3/033009/Multiple-patterning-for-193-nm-immersion/10.1117/1.3599709.full
[4] более: https://www.tomshardware.com/tech-industry/manufacturing/asmls-high-na-chipmaking-tool-will-cost-dollar380-million-the-company-already-has-orders-for-10-to-20-machines-and-is-ramping-up-production
[5] десятков зеркал: https://semiengineering.com/knowledge_centers/manufacturing/lithography/euv/
[6] показала: https://www.nature.com/articles/s44286-025-00273-z
[7] Источник: https://www.trendforce.com/news/2025/09/22/news-researchers-propose-beyond-euv-using-soft-x-rays-potentially-outpacing-high-na-euv/
[8] позволяет: https://www.tomshardware.com/tech-industry/semiconductors/beyond-euv-chipmaking-tech-pushes-soft-x-ray-lithography-closer-to-challenging-hyper-na-euv-b-euv-uses-new-resist-chemistry-to-make-smaller-chips
[9] реакций: http://www.braintools.ru/article/1549
[10] производить: https://irds.ieee.org
[11] показали: https://cosmosmagazine.com/science/engineering/microchip-beyond-extreme-uv/
[12] отсутствие: https://iedm23.mapyourshow.com/mys_shared/iedm23/handouts/28-3_Wed_11933.pdf
[13] необходимость: https://semiengineering.com/luminary-panel-sees-progress-in-euv-pellicle-adoption-as-critical-for-euv/?utm_source=chatgpt.com
[14] поведение: http://www.braintools.ru/article/9372
[15] исследуют : https://pmc.ncbi.nlm.nih.gov/articles/PMC11433861/
[16] ускоряет: https://euvlitho.com/blue-x/
[17] уменьшить зависимость: https://seekingalpha.com/article/4772484-asml-how-secure-is-its-euv-monopoly
[18] Источник: https://habr.com/ru/companies/ru_mts/articles/950922/?utm_source=habrahabr&utm_medium=rss&utm_campaign=950922
Нажмите здесь для печати.