Ставка на упаковку чипов: почему Intel меняет подход к разработке процессоров

В полупроводниковой отрасли последние годы наметился заметный сдвиг. Долгое время развитие шло за счет уменьшения техпроцесса: чем меньше транзисторы, тем выше плотность и производительность. Но сейчас этот подход дает все меньше прироста, тогда как требования к вычислительной мощности, особенно со стороны систем искусственного интеллекта [1], продолжают быстро расти.
Intel решила сделать серьезную ставку именно на продвинутую упаковку чипов. Компания сосредоточилась на технологиях, которые позволяют собирать сложные системы из нескольких кристаллов в одном корпусе, и это постепенно меняет правила игры во всей индустрии процессоров.
Раньше развитие полупроводников шло по простому принципу: уменьшали техпроцесс — росла плотность транзисторов и производительность. Со временем этот подход начал упираться в реальные ограничения. Крупные монолитные кристаллы стало сложно и дорого выпускать: чем больше площадь чипа, тем выше вероятность брака и тем сильнее падает выход годных. Любой дефект на пластине в таком случае обходится значительно дороже. К этому добавляется и физическое ограничение оборудования — размер области экспонирования в литографических установках, из-за которого нельзя бесконечно увеличивать площадь единого кристалла.
На этом фоне отрасль постепенно переходит к сборке систем из нескольких меньших кристаллов вместо большого. Intel делает ставку на продвинутую упаковку как на ключевой элемент этой модели и одновременно как на отдельное направление бизнеса. Компания предлагает партнерам использовать ее мощности именно для финальной интеграции, даже если сами кристаллы выпущены на других фабриках. Это упрощает взаимодействие и дает Intel возможность зарабатывать на сборке и компоновке чипов, а не только на их производстве.
Архитектура на основе чиплетов

Современные процессоры все чаще строят из нескольких небольших блоков, которые называют чиплетами. Каждый из них выполняет свою конкретную функцию: вычисления, работу с памятью [3] или интерфейсы. Их соединяют между собой высокоскоростными каналами, и в итоге получается цельный мощный модуль.
Такой подход существенно повышает [4] выход годных изделий. Маленькие элементы проще изготовить без дефектов, а общий процент брака падает. Разработчики получают возможность применять разные технологические нормы для различных частей системы, подбирая оптимальный вариант под каждую задачу.
В итоге модульность ускоряет весь цикл создания новых продуктов. Отдельные чиплеты проектируют, тестируют и совершенствуют независимо, а потом быстро собирают в готовое решение. Время от идеи до рынка заметно сокращается. Такая архитектура снимает физические ограничения, связанные с размером одной кремниевой пластины. Современные сканеры литографии больше не становятся бутылочным горлышком. Инженеры могут строить системы практически любого масштаба, добавляя нужные блоки по мере необходимости.
Именно переход отрасли к чиплетам и объясняет, почему Intel так активно вкладывается в продвинутую упаковку. Компания видит в этом шанс усилить свои позиции и занять нишу в быстро растущем сегменте, особенно на фоне спроса со стороны систем искусственного интеллекта.
Технологии Intel: EMIB, Foveros и EMIB-T
Именно под этот подход Intel и развивает собственные решения для продвинутой упаковки. Одним из первых стала технология EMIB, представленная в 2017 году. Она использует небольшие кремниевые мостики, встроенные прямо в подложку корпуса, которые обеспечивают плотное соединение соседних кристаллов без необходимости в крупных и дорогих интерпозерах. Так можно эффективнее использовать площадь пластины и снижает стоимость сложных сборок.
Если EMIB работает в горизонтальной плоскости, соединяя кристаллы рядом друг с другом, то следующая технология — Foveros, представленная [5] в 2019 году, — добавляет вертикальное измерение. Она позволяет размещать чиплеты друг над другом, формируя трехмерные структуры и уменьшая расстояние между ключевыми блоками.
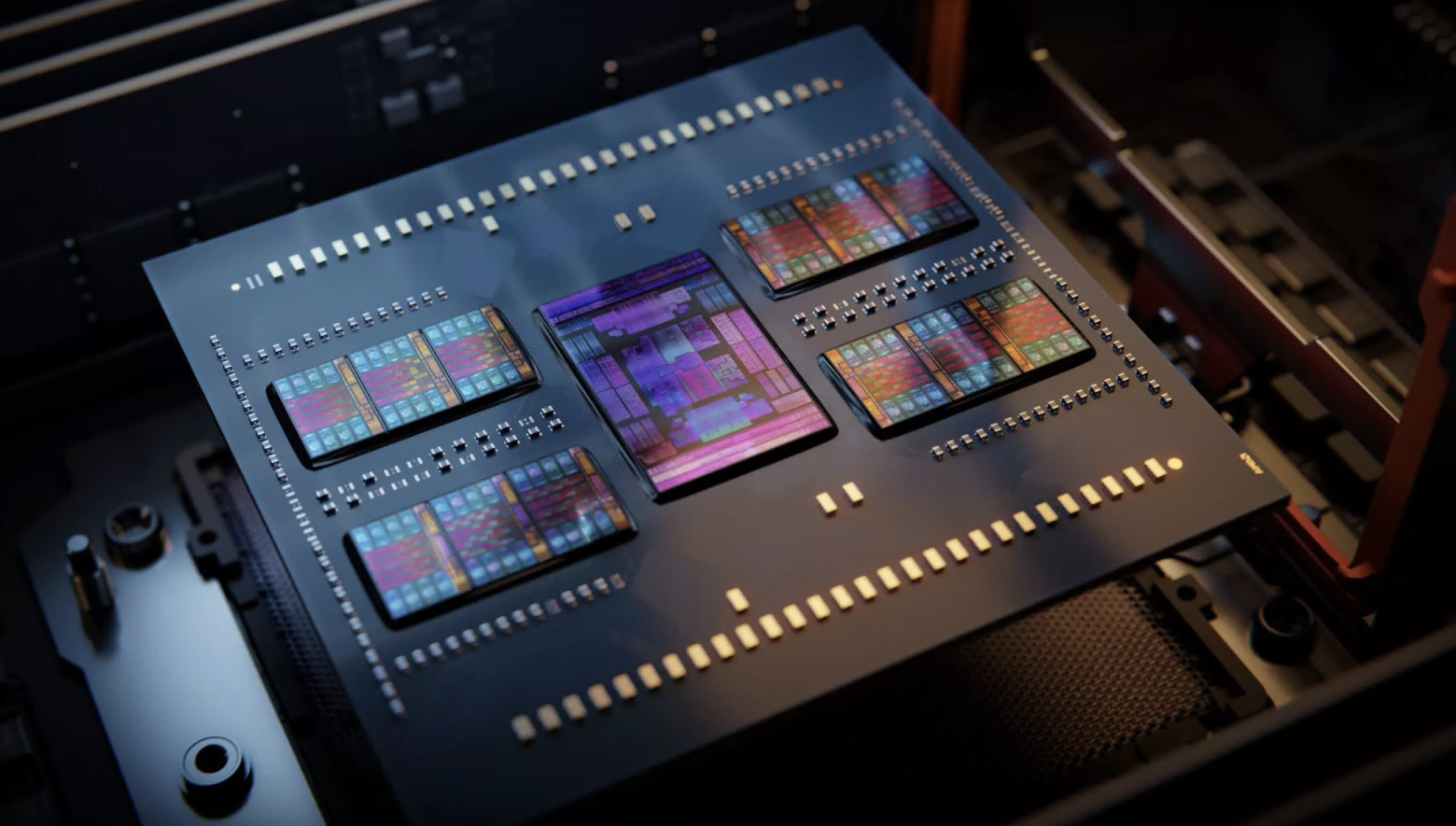
В мае прошлого года Intel анонсировала EMIB-T — улучшенную версию. Новая модификация добавляет сквозные кремниевые отверстия, которые значительно улучшают доставку питания и целостность сигнала. Технология поддерживает память HBM4 и стандарт UCIe на скоростях свыше 32 гигабит в секунду.
EMIB-T позволяет собирать крупные многокристальные модули и использовать десятки кремниевых мостов для их соединения. Такие сборки уже выходят далеко за пределы размеров, доступных для одного кристалла в рамках стандартной литографии, и в ближайшие годы этот разрыв будет только увеличиваться. EMIB 3.5D объединяет горизонтальные соединения с вертикальной компоновкой, формируя гибридную архитектуру с более плотной интеграцией компонентов.
Компания Intel (и не только она [7]) также экспериментирует со стеклянными подложками. Они открывают дополнительные возможности для масштабирования и снижения стоимости в долгосрочной перспективе. Инженеры получают точечный контроль над каждым соединением и могут настраивать систему под конкретные требования заказчика с минимальными переделками.
Расширение производства и работа с заказчиками
Чтобы поддержать это направление не только на уровне технологий, но и в производстве, Intel активно расширяет [8] свои мощности под продвинутую упаковку. Фабрика в Рио-Ранчо, штат Нью-Мексико, возобновила деятельность после серьезной модернизации. На проект направили миллиарды долларов, включая около 500 миллионов, выделенных по программе CHIPS Act. Сейчас Fab 9 и Fab 11X ориентированы на продвинутую упаковку и готовят массовое производство решений на базе EMIB и Foveros, включая новые версии технологий.
В Малайзии Intel расширяет комплекс в Пенанге — один из своих ключевых центров сборки и тестирования, работающий еще с 1970-х годов. Первый этап новых линий планируют запустить позже в этом году, чтобы увеличить объемы и быстрее закрывать растущий спрос со стороны крупных заказчиков из сферы искусственного интеллекта.
Компания ведет переговоры с Google и Amazon — оба разрабатывают собственные процессоры для дата-центров и ищут партнеров для финальной интеграции. Intel рассчитывает занять именно эту нишу и делает ставку на продвинутую упаковку как на ключевое конкурентное преимущество. По оценке [2] руководства компании, сделки на миллиарды долларов в год уже близки к завершению. В Intel подчеркивают, что продвинутая упаковка становится ключевым конкурентным преимуществом и во многом будет определять развитие инфраструктуры искусственного интеллекта в ближайшие годы.
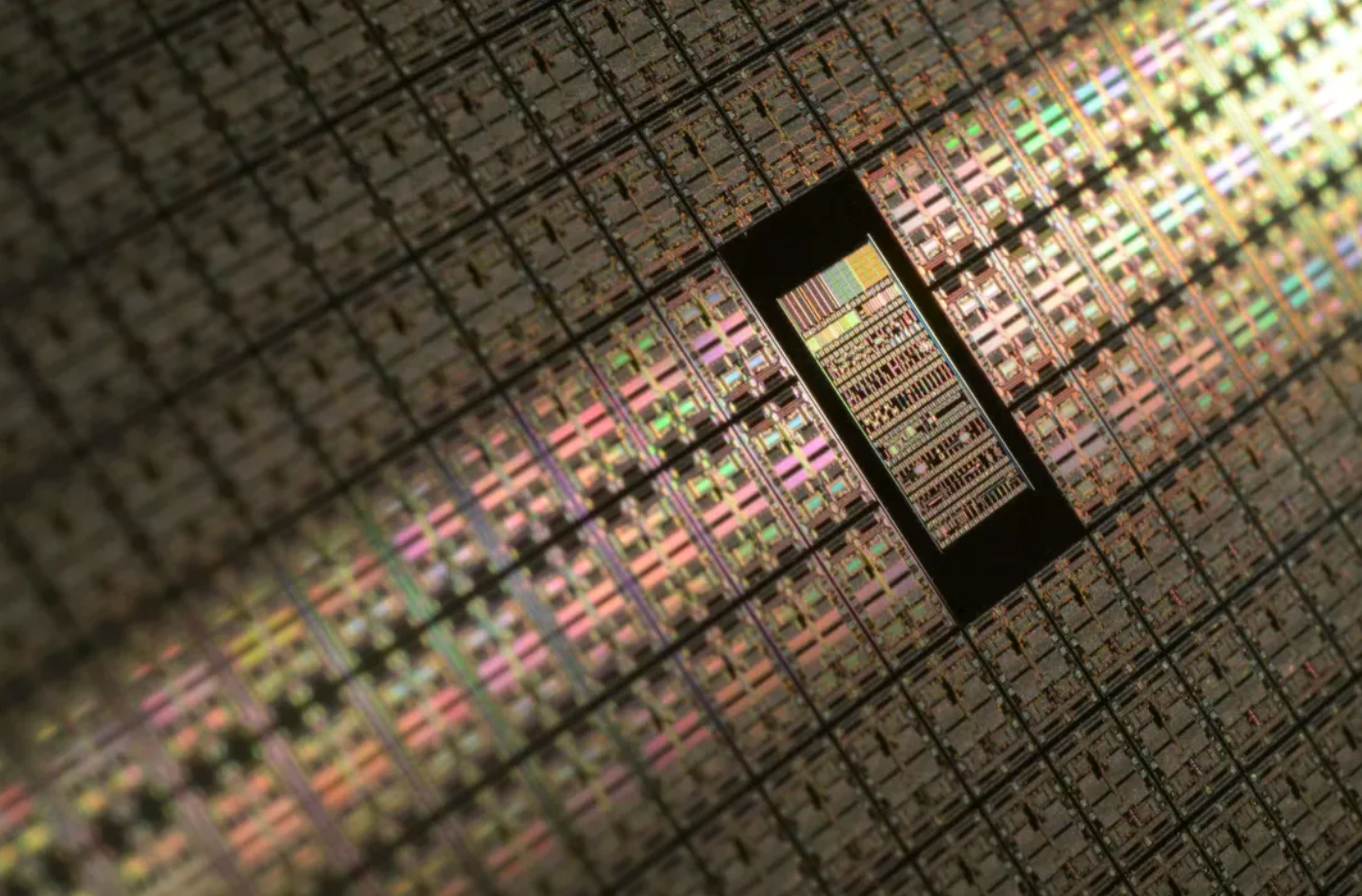
В целом отрасль постепенно уходит от идеи одного кристалла. Модульные архитектуры дают больше гибкости и позволяют быстрее адаптировать продукты под конкретные задачи, поэтому конкуренция все сильнее смещается в область упаковки и сборки. На таком фоне разные производители предлагают свои подходы: например, TSMC развивает решения уровня CoWoS, а Intel делает ставку на более гибкую модель, где заказчик может подключаться к проекту на разных этапах.
В итоге это меняет сами подходы к разработке процессоров. Вместо универсальных решений появляются более специализированные конфигурации, лучше адаптированные под конкретные задачи — от серверных нагрузок до ускорителей для машинного обучения [9]. Модульная архитектура упрощает масштабирование и позволяет быстрее обновлять отдельные компоненты без полной переработки всего чипа, что становится важным фактором на фоне роста требований со стороны ИИ.
Автор: t3chnowolf
Источник [10]
Сайт-источник BrainTools: https://www.braintools.ru
Путь до страницы источника: https://www.braintools.ru/article/28612
URLs in this post:
[1] интеллекта: http://www.braintools.ru/article/7605
[2] Источник: https://www.wired.com/story/why-chip-packaging-could-decide-the-next-phase-of-the-ai-boom/
[3] памятью: http://www.braintools.ru/article/4140
[4] повышает: https://www.amd.com/en/technologies/chiplets
[5] представленная: https://www.intel.com/content/www/us/en/foundry/packaging.html
[6] Источник: https://www.techspot.com/article/2678-chiplets-explained/#google_vignette
[7] не только она: https://habr.com/ru/companies/ru_mts/articles/915120/
[8] расширяет: https://newsroom.intel.com/intel-foundry/intel-opens-fab-9-in-new-mexico
[9] обучения: http://www.braintools.ru/article/5125
[10] Источник: https://habr.com/ru/companies/ru_mts/articles/1021376/?utm_source=habrahabr&utm_medium=rss&utm_campaign=1021376
Нажмите здесь для печати.